nanoMETRONOM AFM

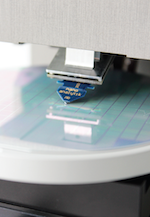 Для получения изображения
Для получения изображения
Особенности и преимущества серии nanoMETRONOM AFM:
- Модульная система, включающая в себя позиционирующий стол, рабочую камеру, систему гашения вибраций, кантилевер SmartActiveProbe
- Высокая скорость отображения в вакууме, воздухе и жидкости
- Быстрая и удобная замена кантилевера
- Адаптация под требования заказчика
Технические характеристики атомно-силового микроскопа nanoMETRONOM
AFM:
|
Функции |
|
|
Рабочий режим |
АС/DC |
|
Отображение топографии |
+ |
|
Отображение амплитуды/фазы |
+ |
|
Построение графика силы |
+ |
|
Сближение образца и зонда |
Автоматическое |
|
Настройка зонда |
Автоматическая |
|
Принцип работы |
Пьезорезистивный |
|
Диапазон сканирования |
Сканнер Pales *: 20 х 20 х 5 мкм Сканнер Adeona: 15 х 15 х 4 мкм |
|
Скорость колебаний наконечника |
по осям X,Y: 5 мм/с по оси Z: 11.67мм/с |
|
Частота сканирования |
0.01 ~ 100 Гц |
|
Мин. измеряемое смещение |
140 пм |
|
Управление с обратной связью |
В режиме реального времени, FPGA |
|
Одновременные снимки |
Фазовый, частотный, амплитудный, топографический |
|
Размеры образцов |
До 100 мм (в стандартной конфигурации) |
|
Опциональные функции |
MFM, EFM, PFM, |
Конфигурации микроскопа
|
Модель |
nanoMETRONOM-HS |
nanoMETRONOM-PJ |
nanoMETRONOM-S2 |
|
Диапазон сканирования |
20 х 20 х 5 мкм |
30 х 30 х 10 мкм |
10 х 10 х 10 мкм |
|
Частота сканирования |
От 0,01 до > 200 Гц |
От 0,1 до 40 Гц |
От 0,1 до > 20 Гц |